NX-Mask技术说明 (使用AFM进行光罩修复的新技术)
Application Technology Center
介绍
光罩是半导体器件制造中用于晶圆纳米图案化光刻过程中的关键部件。光罩选择性地透射或反射光以在目标衬底中产生图案。光罩上的缺陷可能是由吸收层绘制图案时引起的或在光罩处理过程中添加的,这可能会降低晶圆的质量并导致实际元件出现功能缺陷。为了去除这些缺陷,通常会使用各种修复方法,包括电子束、离子、激光和纳米加工。原子力显微镜(AFM)使用几纳米或几十纳米的探针针尖对表面进行成像。AFM广泛应用于半导体工业以及材料、化学、电气、电子和生物工业。 在半导体领域,AFM 的高精度和准确性对于计量和故障分析应用越来越重要。在此,工艺的不断小型化增加了对 AFM 的需求,以发挥缺陷去除工具的作用。基于这一趋势,AFM 的相同表面非破坏性高精度成像功能正在投入到光罩修复应用中。在此应用中,用于对样品表面成像的 AFM 针尖现在用于选择性地去除光罩上的缺陷。此过程会将光罩恢复到其原始功能。帕克通过推出 NX-Mask 自动化 AFM 引领了这一技术发展。本技术说明回顾了使用帕克NX-Mask 修复光罩的概念,并提供了不同应用的示例。
Park Systems NX-Mask
NX-Mask 是为光罩修复而开发的自动化 AFM(图 1)。 NX-Mask 使用 AFM 针尖去除样品表面的非破坏性缺陷。由于 NX-Mask 是一种自动化 AFM,因此光罩修复能够以纳米级精度去除缺陷。此外,它还可以测量亚纳米级的样品表面特征,例如测量表面粗糙度和图案尺寸,因此,除了光罩修复之外,它可以以各种方式用于研究样品。

图1. Park Systems NX-Mask
光罩修复过程
对于光罩修复,NX-Mask 使用单晶金刚石探针,可高效去除缺陷并保持很长的探针寿命。 光罩修复过程包括 1) 全扫描(调查扫描)、2) 修复(缺陷去除)和 3) 修复后成像(图 2)。 全扫描以纳米级精度确定目标缺陷的确切位置和大小。在确定缺陷位置后,NX-Mask 使用原子力显微镜针尖去除缺陷。修复后的图像会验证缺陷去除过程的有效性。通过 AFM 成像结果,可以实时检查每个过程,并且可以通过将全扫描与修复后的成像进行比较来确认缺陷的去除效果。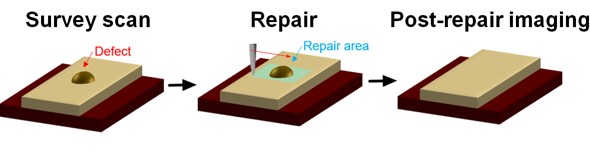
图 2. NX-Mask对光罩的修复过程
Park NX-Mask的光罩修复实例
在 NX-Mask 上的光罩修复中,根据基底材料和缺陷性质分为两类:1) 软缺陷和 2) 硬缺陷。 这两种类型使用上述相同的基本光罩修复顺序,但在基于缺陷类型优化结果时略有不同。图 3 中显示的第一个示例是光罩图案上的软缺陷修复。左边的第一张图片显示了全扫描结果,图案中的缺陷清晰可见。在缺陷去除步骤之后,修复后的图像确认缺陷已成功去除,如右侧第二张图片所示。此外,利用 AFM的非破坏性,可以通过全扫描和修复后成像的比较来确认光罩图案是否保持完整,这表明只有缺陷被选择性地去除而没有对光罩表面造成任何损坏。
图 3.光罩上的软缺陷修复
在软缺陷修复的另一个示例中,从光罩图案中移除了大约 200 nm 高的缺陷(图 4)。通过全扫描步骤识别缺陷,并通过修复步骤有选择地划动。在图 4 的修复图像中,可以看到缺陷的残留物仍然留在图案的底部。然而,部分崩解使得在额外的修复过程中更容易去除,如图 4 中的修复后成像所示。在这里,通过重复修复过程完全去除了图案中的所有缺陷。
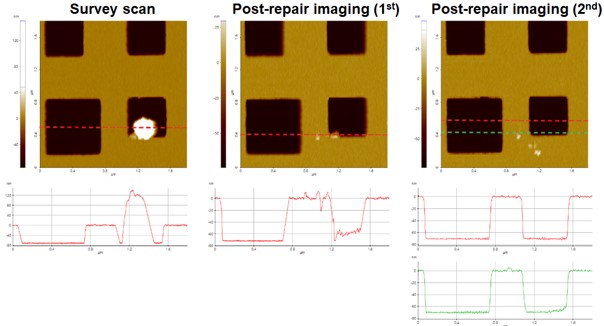
图4. 光罩上的软缺陷修复。在这里,
需要重复缺陷去除步骤来消除缺陷。
图 5 显示了硬缺陷修复的结果,即去除光罩自身的材料。光罩修复过程遵循与软缺陷情况类似的过程,除了在这种情况下,通过使用 AFM 针尖逐步刮擦缺陷部位来去除缺陷,同时保留光罩图案。

图 5. 光罩上的硬缺陷修复
结论
本技术说明演示了帕克NX-mask设备在软缺陷和硬缺陷去除的光罩修复能力。在由全扫描/修复/修复后成像组成的逐步过程中,在光罩表面上准确地识别缺陷,随后选择性地去除/移动缺陷,而不会损坏光罩,正如修复后成像所确认的那样。原子力显微镜在半导体行业的使用不仅仅是简单地测量样品表面,而是以多种方式使用。帕克NX-Mask 的光罩修复方法指向 AFM 的另一个多功能应用,可以跟上半导体行业对光刻技术日益具有挑战性的需求。




