全自动工业 WLI-AFM 系统
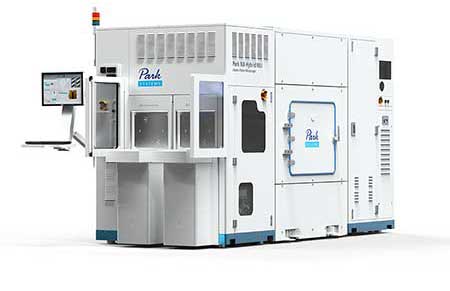
Park NX Hybrid WLI是一款具有内置WLI轮廓仪的AFM,用于半导体和相关制造质量保证。例如半导体前端、后端到高级封装的过程控制,以及研发计量。它适用于那些需要在大面积上进行高吞吐量测量的设备,这些设备可以缩小到具有亚纳米分辨率和超高精度的纳米级区域。
半导体计量的两种互补技术。
- WLI: 白光干涉测量是一种光学技术,它可以对非常宽的区域进行成像,速度非常快,满足高吞吐量测量。
- AFM: 原子力显微镜是一种扫描探针技术,即使对透明材料也能提供精准的纳米级分辨率测量。

| 扫描区域 | 速度 | 横向分辨率 | 垂直分辨率 | 精度 | |
|---|---|---|---|---|---|
| WLI | 大 | 快 | 低 | 高 | 低 |
| AFM | 小 | 慢 | 高 | 非常高 | 高 |
| WLI | AFM | |
|---|---|---|
| 扫描区域 | 大 | 小 |
| 速度 | 快 | 慢 |
| 横向分辨率 | 低 | 高 |
| 垂直分辨率 | 高 | 非常高 |
| 精度 | 低 | 高 |
WLI和AFM在视野,分辨率和速度方面完美结合。
WLI应用需要比WLI 能力更高的分辨率和精度
- 前沿的化学机械抛光计量和监测
- Advanced Packaging
- 全掩模的热点和缺陷检测
- 晶圆级计量
AFM应用需要更大的区域和更高的吞吐量
- In-line 晶圆计量
- 长行程CMP轮廓表征
- 亚埃级表面粗糙度控制
- 晶圆检验与分析
NX-Hybrid WLI 功能
Park WLI系统
- Park WLI支持WLI和PSI模式(PSI模式由电动过滤器变换器 支持)
- 可用物镜放大倍数:2.5X 、10X、20X、50X、100X
- 两个物镜可由电动线性换镜器自动更换
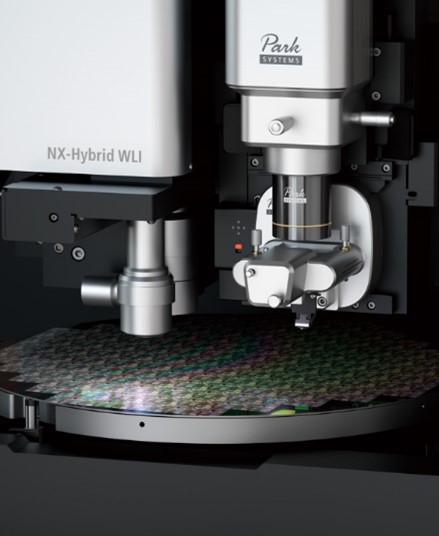
WLI光学干涉测量
- 扫描 Mirau 物镜高度时,由干涉引起的光强变化可以计算每个像素处的样品表面高度
- 白光干涉测量 (WLI) 和相移干涉测量 (PSI) 是两种常用的表面表征技术
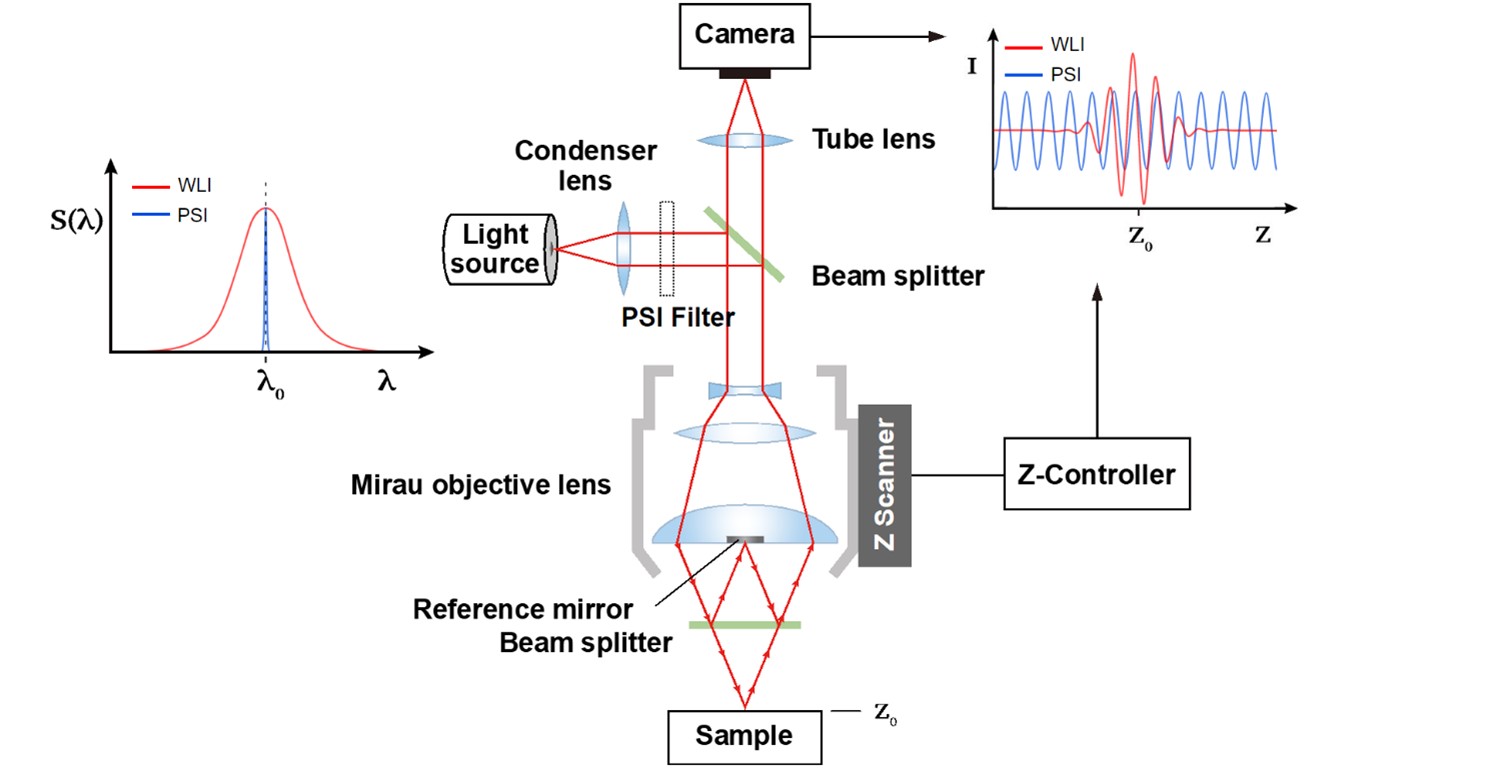
NX-Hybrid WLI 应用
热点检测和审查
热点快速调查和热点缺陷自动审查
- 可以通过比较参考和目标样品区域的图像来检测图案结构的热点
- WLI 的高速“热点检测”可以快速定位缺陷位置,以进行高分辨率 AFM 审查

×




